氧化镓场效应管的器件级瞬态冷却
氧化镓场效应管的器件级瞬态冷却
Samuel H. Kim, et al. Device-level Transient Cooling of β-Ga 2 O 3 MOSFETs[C]. 2022 21st IEEE Intersociety Conference on Thermal and Thermomechanical Phenomena in Electronic Systems (iTherm)
一篇刚刚发表的会议论文,通讯是Samuel Graham和Sukwon Choi。我们知道宽禁带半导体器件主要有两种应用,一个是在射频中用作功率放大器,这种条件下需要给器件一个稳定的直流(DC)偏置;另一个在电路中用作功率切换装置,也就是开关。这两种工作状况是非常不同的,前者是一个稳态的传热过程,而后者在频繁切换过程中,是受到周期性的脉冲加热,是一个瞬态的传热过程。
文章的背景就是说最近的一些工作表明对于实际工作在瞬态热负载条件的器件,也就是频繁切换的开关,基于稳态热仿真结果的热管理方案可能会导致低效的冷却效果。实际上这个问题09年就有人做过了,但是这里重新对氧化镓场效应管研究了一遍,因为氧化镓的热导率很低,导致热扩散系数也很低,所以之前的一些结论可能会不太一样。基本结论就是对于热扩散速度很低的氧化镓,当器件处于快速切换状态时(100kHz,量级约为0.01ms),换高热导率衬底基本没什么用,因为热量传导不到那个位置就结束了。
Device Description
研究了两种热管理方案的影响,一个所谓的底部冷却,就是把衬底换成高热导率的金刚石;另一个是双侧冷却,就是在上面再放上点金刚石。
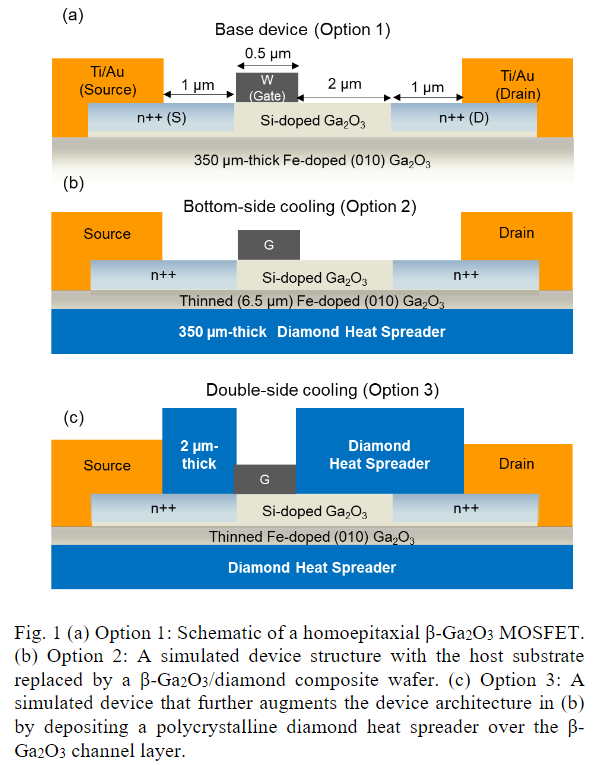
Experimental and Modeling Details
这里模拟的基本过程就是把栅极电压固定,然后在漏极施加一个占空比为10%的瞬态脉冲电压,然后通过数字延迟发生器,控制在\(t_\text{delay}\)时间后发射一个Mirco-Raman激光测温。这里还比较了他们之前用热反射成像测过的GaN HEMT的结果,测量的Bias选取为\(V_g = 4\,\mathrm{V}\),使得沟道处于fully open的状态,这时候产热基本均匀分布在源和漏之间,同时,选取的HEMT的源栅距为2微米,栅长为2微米,栅漏距为15微米(这大概是一个功率器件,RF器件的源漏距离会小很多),GaN厚度为4.4微米,这时候几乎不存在非傅里叶效应了。另外只有热反射成像才有可能测出来非傅里叶效应的表面温度场,Micro-Raman会有一个百纳米到微米的穿透深度。

Results
下面这个是在不同脉冲周期长度下测的和仿的一些结果,氧化镓场效应管的功率为\(1\,\mathrm{W/mm}\),GaN HEMT的功率为\(1.6\,\mathrm{W/mm}\),图(b)是用各自稳态温度归一化后的结果。GaN大概在0.1ms的时间量级达到稳态,氧化镓大概需要10ms的时间量级。
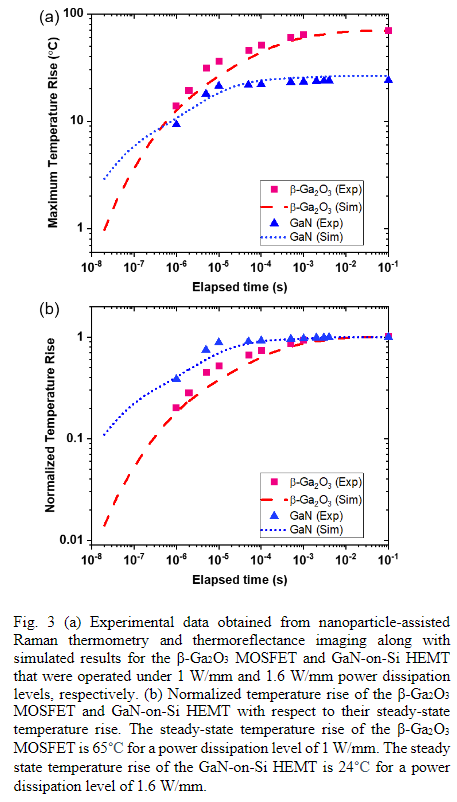
下面这张图展示了不同工作时间下两种热管理方式对沟道结温的影响,当器件工作在~100kHz的快速切换状态下,更换高热导率衬底和原始状况基本没有差别,因为热量此时基本还没穿到衬底里。所以对于高频工作的功率器件来说,更换高热导率衬底很有可能不会对热性能有任何改善,只是增加成本。但是在top-side放金刚石因为离热源很近,在瞬态工作下也是有冷却效果的。
