超宽禁带器件异质界面热输运
超宽禁带器件异质界面热输运
Cheng Z, Graham S, Amano H, et al. Perspective on thermal conductance across heterogeneously integrated interfaces for wide and ultrawide bandgap electronics[J]. Applied Physics Letters, 2022, 120(3): 030501.
今年发表在APL上的一篇perspective,作者是现在在伊利诺伊大学香槟分校的程哲和David G Cahill(H-index 98),佐治亚理工的Samuel Graham(H-index 55),名古屋大学的天野浩(蓝光LED,H-index 102)
这篇文章主要是总结了一下几种异质集成界面,包括转移范德华力键合界面(transferred van der Waals force bonded interfaces),表面激活键合界面(surface-activated bonded interfaces,SAB),等离子键合界面(plasma bonded interfaces),亲水键合界面(hydrophilic bonded interfaces)。宽禁带半导体和超宽禁带半导体主要的应用是功率器件和射频(Radio Frequency)器件,所以这篇文章着重关注了GaN和\(\beta-\text{Ga}_2\text{O}_3\)的异质界面。
我们一般会采用界面热阻(Thermal boundary resistance,TBR)或界面热导(Thermal boundary conductance,TBC)两个量来描述界面的导热特性,他们之间互为倒数, \[ \Delta T / Q= R \] \(\Delta T\)为界面两侧的温差。为方便认识后面各种键合界面的导热能力,这里给出HEMT器件中常见的GaN-SiC外延界面的界面热阻和界面热导的范围,TBR一般处于\(5\sim 20\, \text{m}^2\text{K/GW}\),TBC的范围相应处于\(50\sim 200\, \text{MW}/\text{m}^2\text{K}\),我们在描述TBR时一般采用\(\text{GW}\),而描述TBC时一般采用\(\text{MW}\)。
界面
构造异质界面最常用的方式就是在一个材料上面生长另一个材料。外延生长技术,比如分子束外延(Molecular beam epitaxy,MBE),金属有机化学气相沉积(Metal organic chemical vapor deposition,MOCVD),但是这种技术受到晶格常数不匹配和生长过程的限制。其他生长技术,比如溅射沉积(sputter deposition),热蒸发(thermal evaporation),原子层沉积(atomic layer deposition,ALD),可以生长金属和一些介电材料,但是长出来的材料通常是多晶(polycrystalline)或者无定形材料(amorphous)。不同于生长技术,异质集成(heterogeneous integration)技术可以在两种单晶材料之间直接构建界面,无视他们之间的晶格常数不匹配,相当于把两个单晶直接贴起来,而不是在一种材料上生长另一种。
异质集成
直接把两种单晶贴起来,键合起两种界面间的作用就是化学键,而化学键的本质就是一种相互作用,也就是力。所以不管是什么键,在MD里指定距离和能量的关系就可以进行模拟了。异质集成中的相互作用可能是范德瓦尔斯力,氢键,离子键,强共价键,或者他们的组合。

van der Waals force bonding
最简单的异质集成技术就是转移键合,此时薄膜(channel layer)和衬底间一般是靠范德瓦尔斯力连接在一起的,这种技术在\(\beta-\text{Ga}_2\text{O}_3\)器件里有比较多的应用,因为氧化镓特殊的晶体结构,氧化镓薄膜可以直接从体晶体中机械剥离,然后转移连接到衬底上,比如金刚石。由于范德华力很弱,因此这种键合方式形成的界面的热导一般非常低,TBC一般处于\(10\sim 30\, \text{MW}/\text{m}^2\text{K}\)的范围内,\(\beta-\text{Ga}_2\text{O}_3\)和金刚石的异质界面大概在\(17 \text{MW}/\text{m}^2\text{K}\)左右,相当于129微米金刚石的热阻,我们把这个等价长度称之为Kapitza长度。这个界面热阻很高,相当于起到了一个大滤波器的作用,热流通过这个界面完全被拉平了,没有任何在高热导率衬底中扩散的余地了,所以此时这个高热导率衬底也就没什么意义了。
surface-activated bonding
SAB是一种室温键合技术,避免了高温键合时因晶格不匹配而产生的热应力。这种技术的流程一般是先把两个晶片抛光,然后用Ar离子束进一步清洁和激活,然后施加5Mpa左右的压力把他们压到一起,这种方式产生的界面一般会有几纳米的无定形层,并且会混进去一定量的Ar原子,可以通过退火的方式消除掉一部分。
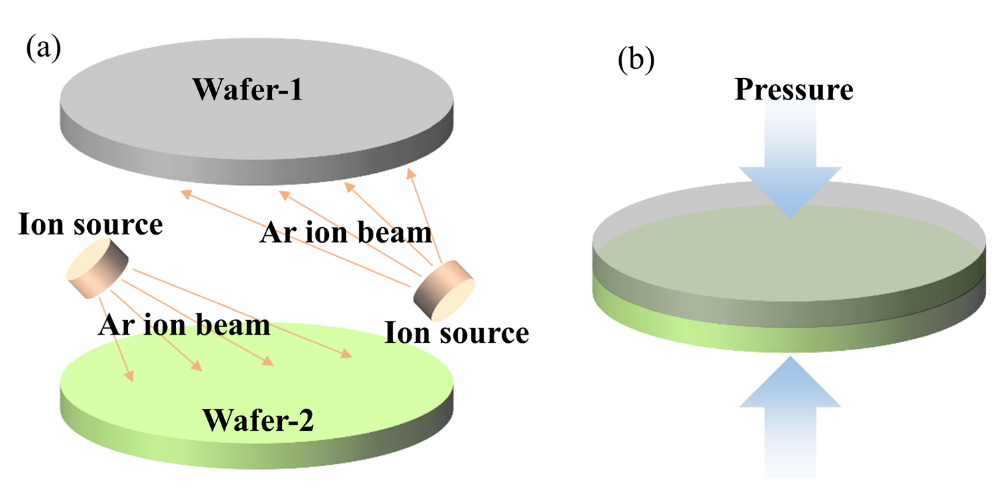
这种方式键合的界面一般比较好,下面这几张图是用扫描电子显微镜照出来的SAB键合的界面,如(c)所示,直接键合的GaN/SiC的间会存在无定形层,TBC在\(170 \text{MW}/\text{m}^2\text{K}\)左右,在1000℃高温退火10分钟后,TBC可以达到\(230 \text{MW}/\text{m}^2\text{K}\)。\(\beta-\text{Ga}_2\text{O}_3\)—SiC界面用\(\text{Al}_2\text{O}_3\)做过渡的TBC可以达到\(88 \text{MW}/\text{m}^2\text{K}\),其中氧化铝层是为了保证退火后界面的均匀性。GaN和金刚石集成也有含Si过渡层和直接集成两种模式,对于直接键合(f),其过渡层的厚度可以达到仅有1.5nm。
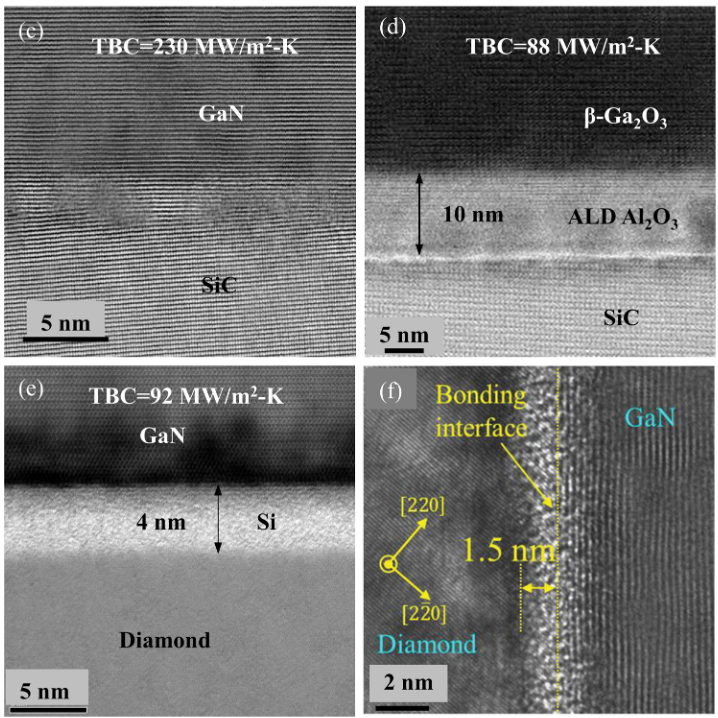
plasma bonding
等离子键合可以形成强相互作用的界面,把氧化铝用ALD沉积在待键合的两个单晶上,之后用氧等离子激活两个表面,然后把他们贴在一起(?)形成界面,之后可以再进行退火操作提高一下界面形貌。
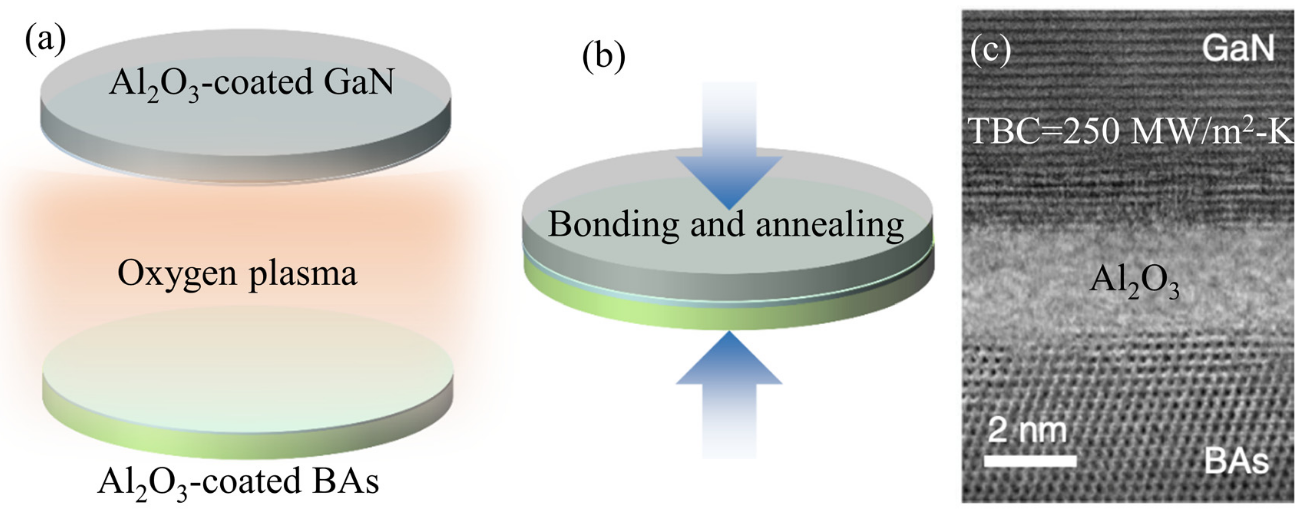
这种方式做出的GaN-BAs(砷化硼,\(k\sim 1300\,\text{W/mK}\))氧化铝过渡层只有2nm,界面热导可以达到\(250 \text{MW}/\text{m}^2\text{K}\)。当然砷化硼的禁带宽度太小了(1.5 ev),用它做衬底容易被击穿..
hydrophilic bonding
氢键键合技术简单、成本低,不需要真空环境,还是先把需要键合的界面抛光,然后用硫酸/过氧化氢清洗及氧离子轰击让表面长出一些OH基(OH termination),然后让表面相互接触,通过热脱水反应使得两个界面通过 -O- 连在一起,这一过程一般需要在250℃左右的环境持续一天。这种技术长出的界面,过渡区域可以小于1nm,但是界面热阻还没有测过。(这个(e)照出来的结果确实很好看.. )

所以可以看到,实际上在很多蒙特卡洛模拟和分子模拟中对界面的处理是很粗糙的,很难完全描述不同类型的界面,更不用提用什么可靠的模型做模拟的input了,一般只能简单的估计一下。
simulation
所以界面热阻对结温的影响的一般规律就是随着TBC的增加影响效果越来越弱,同时在栅极越窄的情况下,改善TBC就越有效果,因为此时热量更集中,在衬底中有更多的扩展余地。
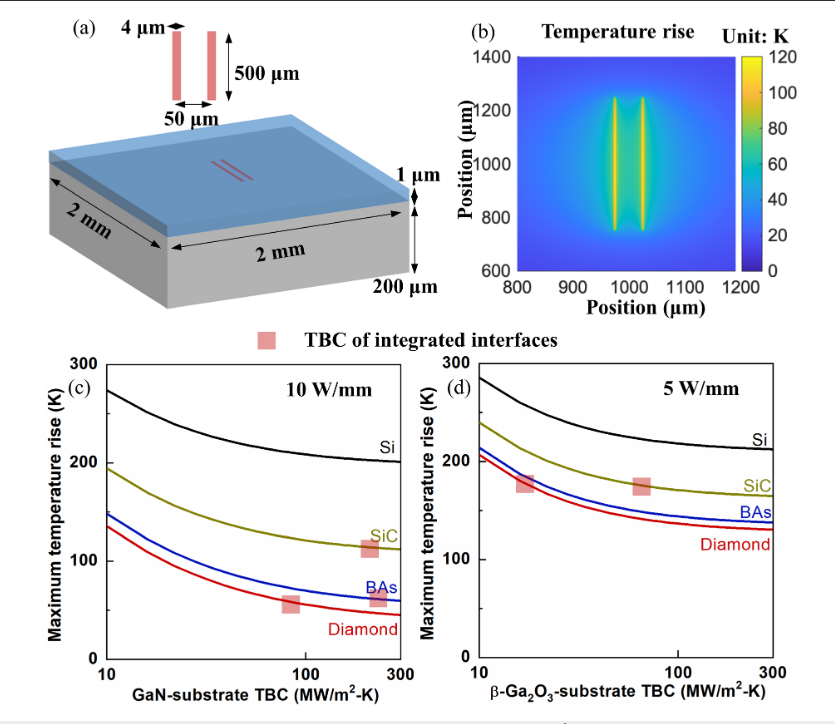
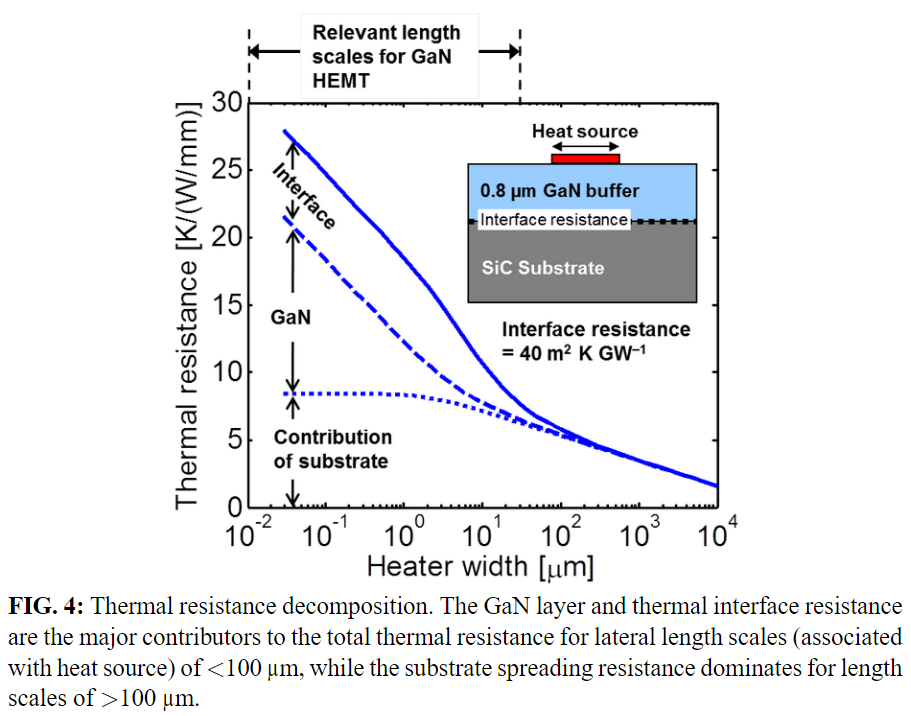
outlook
困难:
多层内部界面结构的TBC高通量原位热表征
多层结构需要更多的拟合信息,同时对于TDTR来讲,越深的界面的测量的敏感度就越低,而且TDTR还需要在样片上面加工一个金属电极。此外TDTR的穿透深度比较小,对于\(1\,\text{W/mK}\)的材料来说,穿透深度只有几百纳米,即使对于高热导率材料,TDTR也只能测到几微米深的界面。对于异质集成界面,目前测出来的TBC就上面那些数据。
界面结构和TBC间的映射
界面热阻的建模.. 界面处存在过渡层、无定形层、离子、缺陷、扩散层等等,怎么厘清这些东西的贡献并以此改善界面结构以提高TBC?理论和模拟都存在很多问题.. 现在有一些工作是通过引入中间过渡层来帮助建立两层材料间的声子热输运以提高TBC。
Applying integrated thermally con-ductive interfaces to power devices remains an open area. Device demonstrations and characterizations of cooling performance will be exciting but challenging.