认识GaN-HEMT
认识GaN-HEMT
典型GaN HEMT器件结构
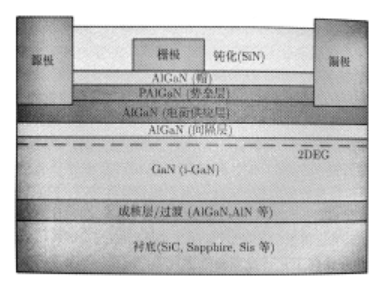
晶圆制备包括衬底制备和外延工艺两个环节,衬底(substrate)是由半导体单晶材料制造而成的晶圆片,外延(epitaxy)是在单晶衬底上生长一层新单晶的过程,新单晶可以与衬底是同一材料(同质外延),也可以是不同材料(异质外延)。我理解就是外延技术可以长出来更好的单晶,还可以调控掺杂浓度等等,器件制作在更好的外延层上,性能也会有很大提高。Si器件可以在Si衬底上长出Si外延层出来,但是由于GaN很难做出来单晶,因此基本都是异质外延,比如在SiC或者Si衬底上长GaN外延薄膜。异质外延需要保证两种材料之间的晶格匹配度,比如SiC和GaN的晶格失配率很高,直接生长的话界面失配、缺陷都会很多,会降低器件性能。因此在衬底和GaN外延层中间引入AlGaN或者AlN的成核层(nucleation),来减小界面失配。成核层上面叫作GaN缓冲(buffer)层,厚度在微米级,用于形成2DEG;再上面的电荷供应层是重N型掺杂的AlGaN,用来提供电荷形成2DEG,但是由于重掺杂会导致较高的电子散射率从而降低2DEG中的电子迁移率,因此在重掺杂的AlGaN下面再放一层无掺杂的AlGaN间隔层(spacer),间隔层越厚对降低电子散射的作用越明显,但也会限制电子进入2DEG中,降低电子浓度。重掺杂的AlGaN上面分别是AlGaN势垒层(barrier),AlGaN/GaN帽层(cap)和SiN/SiO2钝化层(passivation),这些层用来辅助维持器件的性能,钝化层处在栅极与源极和漏极中间,减小漏电,增强源漏极欧姆接触和击穿电压。
GaN HEMT(high electron mobility transistor)由于在GaN和AlGaN界面处形成的2DEG而具有高电子迁移率。电子和声子一样都是载流子,载流子受到的散射越多,其输运也就越受抑制,平均自由程越短,输运系数越低。2DEG中的电子由于只能在界面处横向运动,纵向运动被抑制,因此其受到的体材料中的散射大幅降低,因此具有非常高的电子迁移率。
能带结构和能带图
能带结构(band structure)和能带图(band diagram)是两个概念,能带结构是用来描述类似于声子色散关系的电子能带结构,能带结构是画在波矢空间上的;能带图是用来描述器件中载流子的能级分布的,描述的是导带底、价带顶、费米能级等随位置的变化,用来描述能带结构的变化,是画在实空间上的。下面这张图是电子的能带结构,
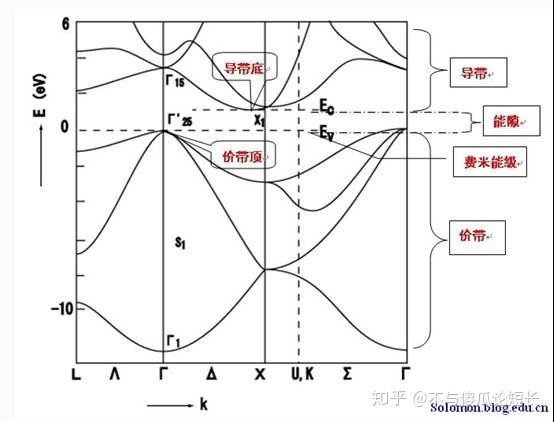
而半导体器件的能带图是描述能带结构图中导带底和价带顶随位置变化的情况,能带图中的每一点实际上都对应着一个能带结构,能带图是理解PN结、MOSFET、肖特基势垒和2DEG等的基础。
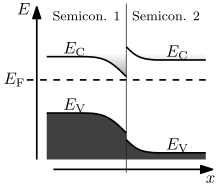
为什么只画价带顶和导带底的变化就可以了呢?因为对于电子满足的费米-狄拉克分布来说,在能量超过费米能级后,电子处于对应能量的态的概率是指数衰减的,因此有电子填充的态都集中在价带的底部,空态都集中在价带的顶部,因此画出来这两个点就基本足够描述了电子的分布情况了。用中文搜索能带图,搜出来的基本都是能带结构图,TCAD仿真给出来的是band diagram,VASP计算给出来的是band structure,我也混淆了这两个概念好久。
费米能级
费米能级在书中的定义是温度为绝对零度时固体能带中充满电子的最高能级,这个定义并不能看出来这个量到底有什么用.. 很多概念在不同的应用中体现出它的不同特性,需要用不同的图像去理解。在半导体的能带图中,费米能级直接与载流子浓度相连,电子会从费米能级高的地方流向费米能级低的地方,空穴反之。我们画出了半导体中的能带图(导带、价带、费米能级),直接就大致确定了载流子的浓度分布,也知道了载流子曾经或者现在发生了什么样的运动。把费米能级和载流子浓度联系起来的一对公式为,
\[\begin{aligned} n &= n_i \exp(\frac{E_F - E_i}{kT}) \\ p &= n_i \exp(\frac{E_i - E_F}{kT}) \end{aligned}\]其中\(n\)和\(p\)分别为电子和空穴的浓度,\(n_i\)为半导体的本征载流子浓度,\(E_F\)为费米能级,\(E_i\)为本征费米能级,略微偏移于禁带的中线(即导带底和价带顶的中线)。在非平衡状态下,\(E_i\)的定义变为准费米能级,但我感觉这些都是一个东西,无非是引入了一个局域平衡假定,就好像热力学中的温度定义和传热学中的温度定义一样。
在热力学里,我们将平衡定义为一个孤立系统的一种状态,该系统中不发生随时间变化的宏观状态。像温度和压力这些物理量只在平衡状态下才有意义。当系统处于非平衡状态时,会发生输运过程。系统发生稳态导热时,并不是处于平衡状态。此时尽管系统状态没有发生变化,但由于系统不是孤立系统,所以这种稳定状态并不违背平衡状态的定义。而处于非平衡状态下系统的问题是,其温度在热力学范围内无法定义。这就使得我们前面介绍的本构关系看起来是毫无意义的。我们可以引进局域平衡的观点来解决这个问题。虽然整个系统可能不是处于平衡状态下,但是系统内的每一点都离平衡状态不远。系统内围绕每一点周围的极小区域可以近似为处于平衡状态,这样就可以定义局部温度、压力和化学势。但对于什么情况下可以假设为局部平衡状态,还没有建立严格的判别准则,也不清楚这个区域要小到何种程度。我们可以进一步探讨,当系统尺寸比这个最小尺寸还要小时会发生什么。
因此在半导体中掺杂,就相当于改变半导体的费米能级,对于N型掺杂,\(E_F\)更靠近导带,此时电子浓度高于空穴浓度,P型掺杂则相反。只要给出了一块材料的费米能级和禁带中线(\(\approx\)准费米能级)的能量差,我们就可以计算这块半导体中的电子和空穴的浓度了。

几种典型结构的能带图
PN结
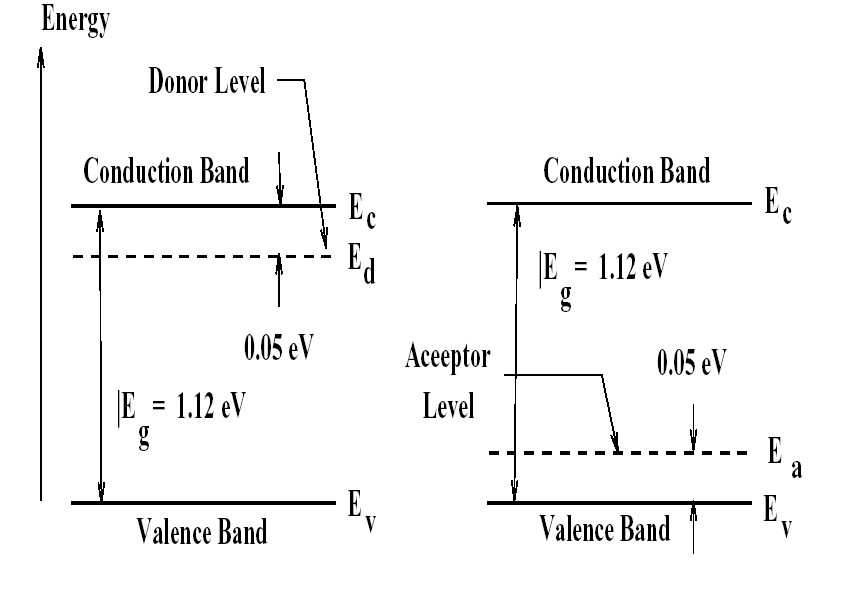
P型半导体中,空穴主导,因此费米能级靠近价带;N型半导体中,电子主导,因此费米能级靠近导带。把他们两个像下面这样连接到一起,构成了一个PN结。电子会从费米能级高的地方跑到费米能级低的地方,空穴的运动方向相反,随着电子和空穴的移动,在没加外部电场下,半导体内的费米能级最终趋于一致,整个半导体中也就没有净电流。
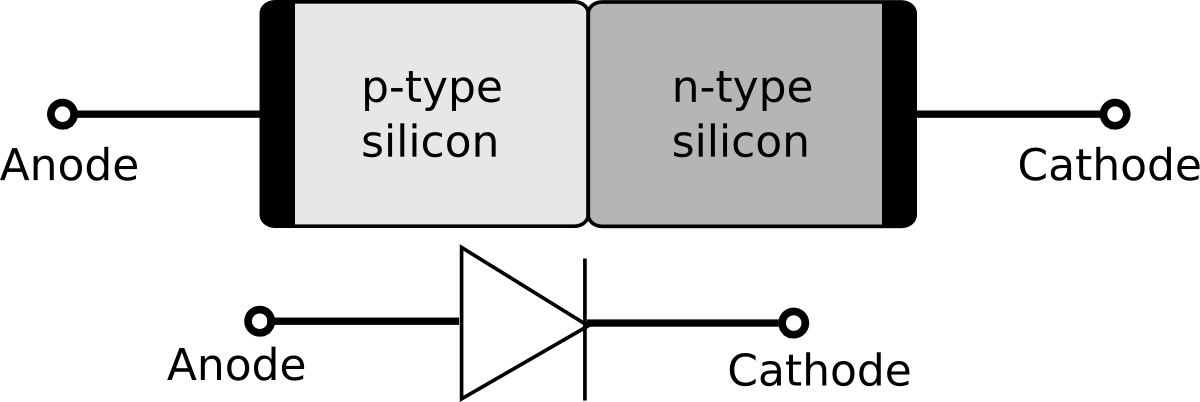
因此最终PN结中的能带图是下面这个样子的,在\(x>x_n\)的地方,是N型半导体的能带,在\(x<-x_p\)的地方是P型半导体的能带。处于平衡状态时,整个PN结中的费米能级相等,在PN中间,形成了一个耗尽区,由于整个半导体中的能级必然是连续变化的,因此在耗尽区发生了能带弯曲。
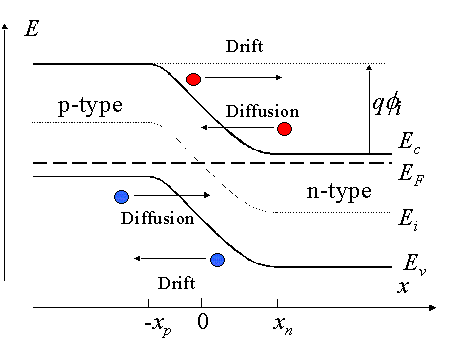
从这张图中可以获取很多信息,
静电势
能带图是以电子的能级为基础画的,能级越高,电势越低:\(V(x)\propto -E_c(x)\),静电势的分布把这张图左右倒过来
电场
对电势分布求梯度就得到了电场:\(E \propto \mathrm{d}E_C(x)/\mathrm{d}x\),对于PN结来说,电场在PN结的过渡区域达到峰值。
载流子浓度
观察一下费米能级和准费米能级之间的关系就可以了,\(\log p(x) \propto E_i(x) - E_F\)
空间电荷分布 \[ \rho(x)\propto p(x)-n(x)+N_D(x)-N_A(x) \] 施主把电子都捐出来(基本上),这些电子和半导体自己激发出来的电子没什么区别,大家都是按照一样的规律在半导体中分配的,受主相当于把空穴捐出去了,掺杂引入的载流子浓度远大于本征激发的载流子浓度。留下来的施主掺杂和受主掺杂则分别带正电和负电,这些施主和受主的浓度分布是由掺杂过程本身决定的,而电子和空穴的浓度是受半导体中的各种物理过程决定的,比如施加的栅电压或者漏极电压。根据电荷守恒,整个半导体中的净空间电荷是为0的,但是受掺杂及电压的影响,会存在电荷空间分布。对于PN结来说,\(x<0\)为均匀的施主掺杂,\(x>0\)为均匀的受主掺杂。对于PN结,在耗尽区左侧,电子浓度基本和施主浓度相同,不存在净电荷,在\(-x_p\rightarrow=0\)这一段,电子浓度迅速减小,空穴浓度增加,PN结开始带正电,右侧反之。当然如果想要定量求解的话,我们需要求解静电场的泊松方程 \[ \nabla^2 V = -\frac{\rho}{\epsilon_0} \] 来求得空间的电荷分布。Anyway,从能带图我们能够定性地得到半导体中的很多信息,如果想要定量求解,可以参考之前写过的,求解耦合的电子-空穴对流扩散方程和静电场泊松方程。
MOSFET
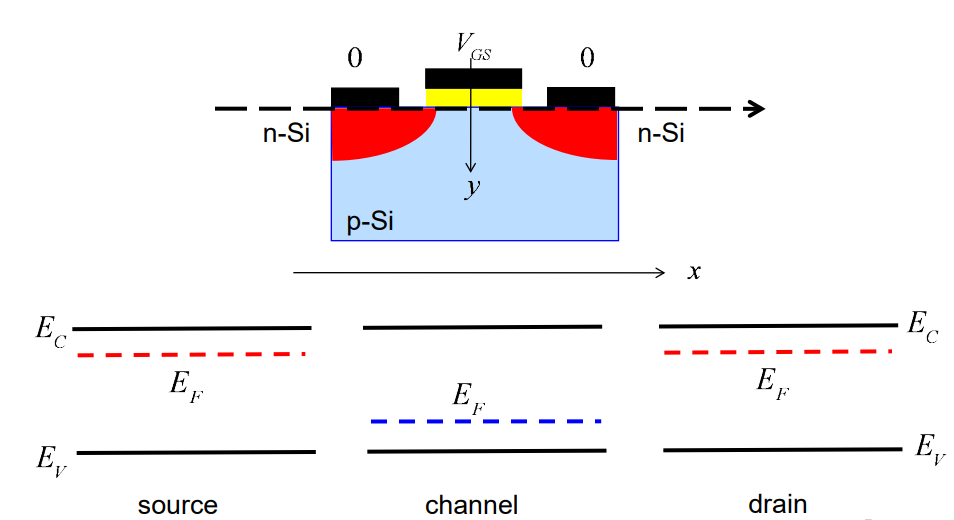
N型MOSFET横着看过去,相当于两个PN结,源极和漏极下面均是N型掺杂,栅极下面是P型掺杂,因此在不加任何电压的情况下,MOSFET栅极下方的能带图如下图所示。费米能级为一条直线,晶体管内没有电流流动。同时我们可以看到,在channel处有一个非常高的能量势垒,源附近的电子几乎没有办法跨过channel到达漏极,此时晶体管处于关闭状态。所以我们控制栅电压来控制晶体管,本质上是控制沟道处的势垒高度。
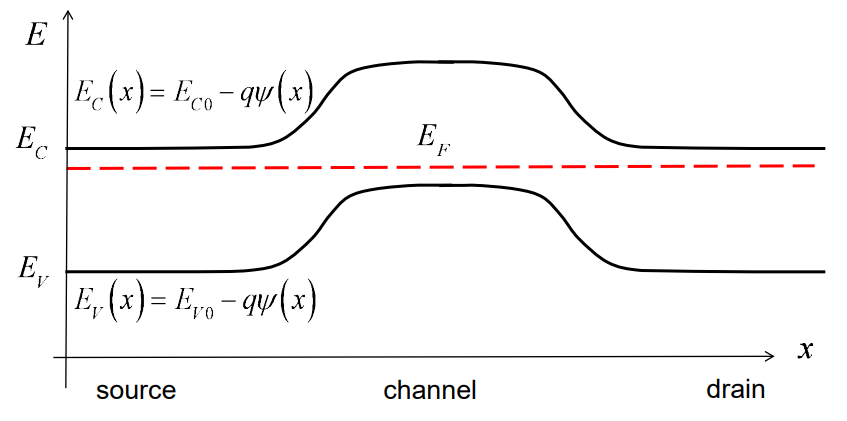
所以一个为了让晶体管处于开的状态且有电流流动,我们需要在栅极施加正电压,把栅极处的能量势垒拉下来,让电子可以跨过势垒,channel导通;同时我们需要在漏极施加正电压,把漏极处的费米能级拉下来,使得源极的电子可以沿着倾斜的(准)费米能级轨道滑下来,这就是在能带图的角度,对MOSFET工作原理的基本理解。所以为什么MOSFET会存在一个饱和电流呢?因为当把漏极的能量拉到足够低时,此时限制电流的是channel处的势垒高度,即电子的隧穿概率了,越过势垒的电子已经全部流到漏极去了。
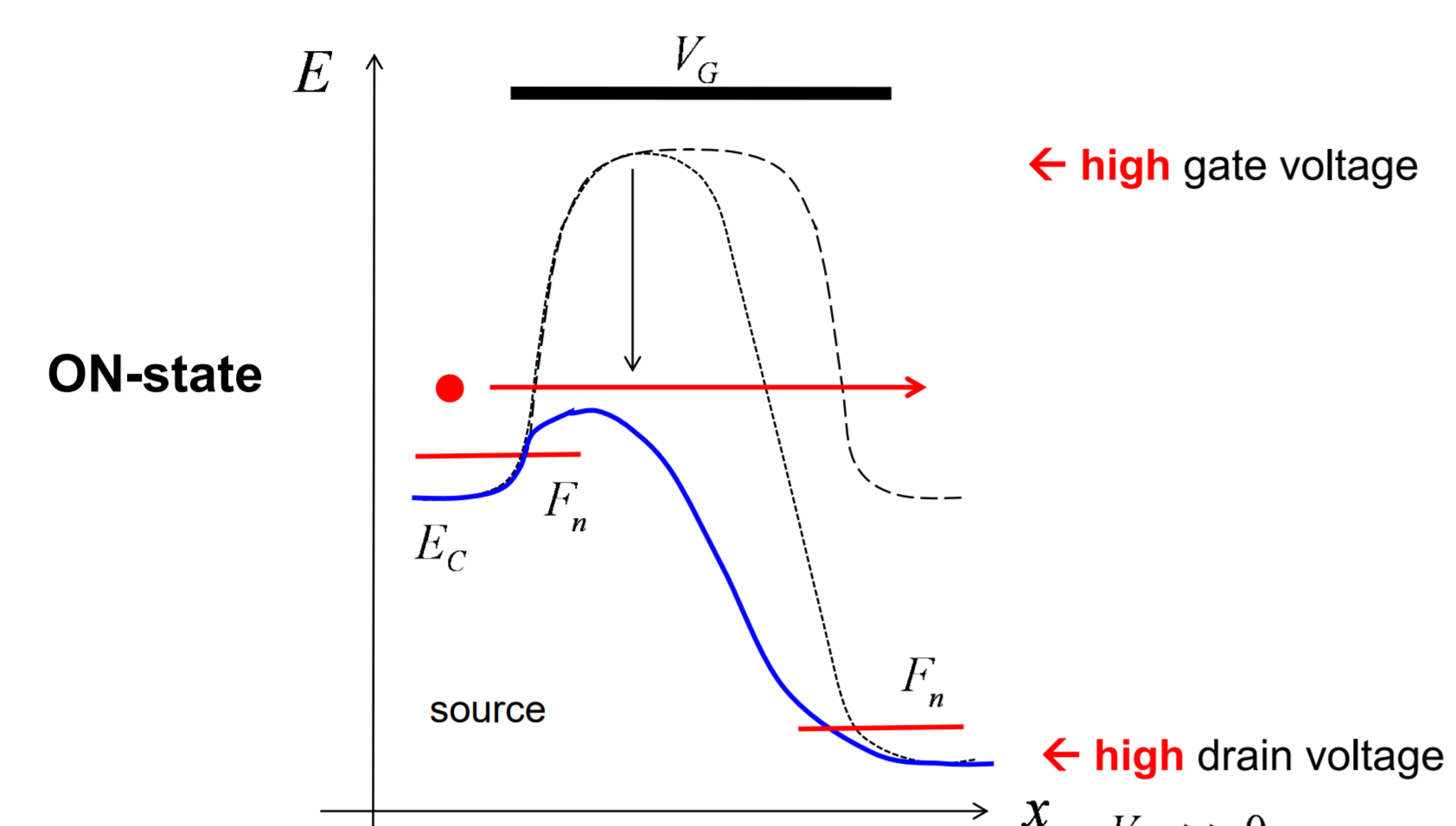
因此,
A MOSFET (and most transistors) are barrier-controlled devices.
当然,当这个势垒足够窄的时候,即沟道足够短的时候,量子隧穿效应是显著的,电子不再需要跨过势垒跑到另一边了,它可以直接穿过势垒。因此此时即使在栅电压很低的时候,晶体管内也有大量电流,这个晶体管就没法工作了,所以MOSFET存在一个尺寸极限。

2DEG
二维电子气用上面的能带图去理解,本质上是一个量子阱,barrier,把电子困在里面。下面讨论的这些,实际上就是讨论这个量子阱是怎么形成的。
极化
极化就是电介质内部的正负电荷的相对位移,产生电偶极子。
Ⅲ组氮化物比如GaN的一个主要特点就是极化矢量的存在,包括自发极化和压电极化。极化引起的主要效应就是异质界面处由极化发散引起界面电荷的形成。自发极化是指在没有外电场作用时,由晶格结构引起的极化状态。Ⅲ族氮化物存在闪锌矿和纤锌矿两种结构,分别如下面左右两图所示。闪锌矿结构各个化学键键长相同,因此不存在自发极化性质。纤锌矿结构中,一个原子与其最近四个原子形成的键长不同,沿[0001]方向的键长要大于其余三个键长,因此最近邻四个原子形成的负电荷中心与正电荷中心并不重合,正负电荷产生了电偶极矩,形成了内建电场。极化矢量的方向为从负电荷指向正电荷,因为极化矢量的方向是与内建电场的方向相反的,而电场方向是由正电荷指向负电荷的。

对于闪锌矿结构的GaN来说,根据GaN膜上表面原子层是Ga原子还是N原子分为Ga面GaN和N面GaN,相当于分别以Ga和N为中心原子。
对于N面GaN,N为中心原子,自发极化矢量方向向上,因为正电荷向上偏移,存在一个由上指向下的内建自发极化电场。

压电极化的图像也比较好理解,三个键受到拉伸或者压缩应力,正负电荷中心发生偏移,产生极化。下面这三层白色的是GaN,灰色的是AlGaN。以左侧Ga面GaN为例,当GaN和AlGaN都不存在应力的时候,只有自发极化矢量,方向均向下。对于b)的情况,当在GaN上外延生长AlGaN时,由于AlGaN的晶格常数小于GaN,即AlGaN的晶胞边长小于GaN,此时在Ga面上,Ga上面连着的三个较短的Ga-N键受到拉伸应力,正负电荷中心偏离就更远了,此时压电极化的方向与自发极化方向相同。对于c),在AlGaN上长GaN时,GaN的受到压缩应力,三个较短的Ga-N键键长压缩,产生了与自发极化方向相反的压电极化。
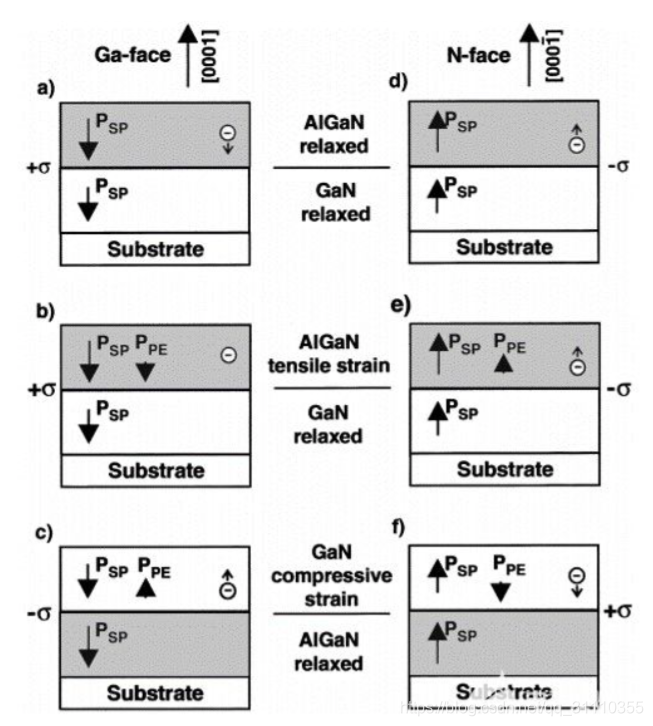
能带图
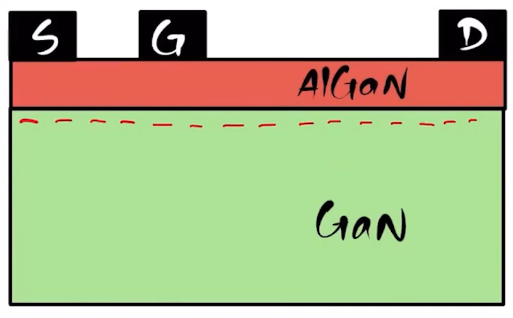
对于一般的N型掺杂的AlGaN来说,在AlGaN层中,AlGaN/GaN界面的正极化电荷和AlGaN层顶部的负极化电荷产生内建电场,使能带及费米能级向界面倾斜。在内建电场的作用下,AlGaN中的电子移动到正电荷处并在那里积累,在AlGaN中留下正空间电荷,弯曲能带,并使费米能级再次变平(如果体系中不存在电流,那么费米能级始终是平的)。电子的迁移将减少AlGaN层的内建电场,从而使倾斜的能带变得更加平坦(负反馈)。因为GaN的费米能级低于AlGaN的费米能级,因此AlGaN一侧的电子一旦接触到GaN,就将跑到GaN中并形成2DEG,GaN的能带也会因此发生弯曲,这一过程一直持续到AlGaN和GaN的费米能级相等。

参考
Semiconductor Fundamentals,Mark Lundstrom
Fundamentals of Transistors,Mark Lundstrom