HEMT, 2EDG, self-heating
HEMT, 2EDG, self-heating
HEMT

.jpg)
在HEMT中,能够运动的电子都被束缚在AlGaN/GaN的界面上GaN层顶部的几个纳米左右的区域,因此这些电子也被称为二维电子气(2DEG),GaN层顶部的这一区域又被称为沟道。由于电子被束缚在这个量子阱内,无法向第三个维度运动,导致它受到的散射强度很小,电子迁移率很好。对于AlGaN/GaN HEMT来说,由于宽度方向(垂直屏幕方向)远大于长度方向(源指向漏的方向),对HEMT的分析可以简化到二维情况,即一个宽度截面的电子运动,仿真得到的器件各种性质的单位也就都是xx每毫米,如上图所示。此时GaN HEMT的漏极电流密度(A/mm,单位宽度方向)就可以表示成, \[ I_D(T)=q n_s(x, T) v(x, T) \] 其中\(n_s(x,T)\)和\(v(x, T)\)分别是2DEG的面电子密度( sheet number density,相当于已经把厚度方向积分掉了)和沟道方向的平均电子漂移速度。所以HEMT器件的电流驱动能力由两个因素决定,分别是2DEG的密度和电子速度,电子速度也就相当于是迁移率。考虑提高2DEG的电导,也相应是从这两个因素出发,考虑自热效应引起的输出电流降低,也可以从这两个因素进行分析。
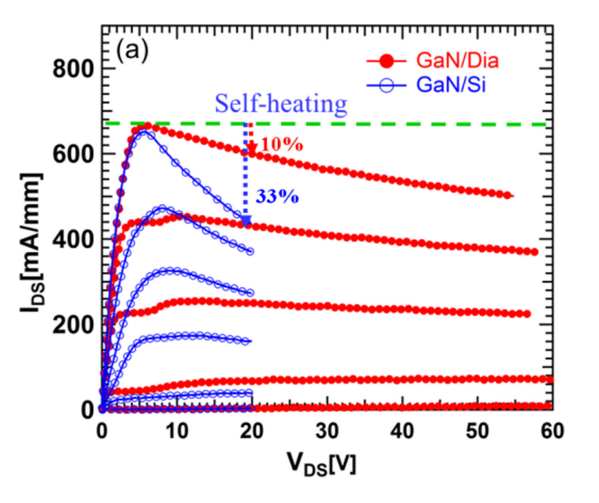
2DEG
在AlGaAs/GaAs材料体系中,2DEG的电子主要来源于AlGaAs和GaAs中的施主掺杂电离。然而在AlGaN/GaN异质结中,即使未人为掺杂,也能够形成达到\(1\times 10^{13}\,\text{cm}^{-2}\)量级的2DEG。即使考虑背景n型掺杂电离产生的电子,在常见的背景掺杂浓度\(1\times 10^{15}\sim 1\times 10^{16}\,\text{cm}^{-3}\)内,也需要\(10\sim 100\, \mathrm{\mu m}\)厚的材料薄膜才能产生如此高密度的二维电子气,而通常AlGaN/GaN异质结材料的厚度仅为\(1\sim 3\,\mathrm{\mu m}\),因此体掺杂电离只能为2DEG提供少量电子。目前大家比较接受的一个解释是AlGaN层的表面存在施主态,AlGaN和GaN的自发极化会在各层表面产生极化电荷,极化电荷会诱导出内建电场,内建电场导致能带弯曲,从而使得施主态高于AlGaN的费米能级,大量电子滑落到异质结GaN一侧,形成一个又窄又深的量子阱,电子们被困到了阱里。为了理解这部分,首先需要回顾一下泊松方程以及高中物理中的平行板电容器,并且简单地了解一下自发极化。
泊松方程描述了电场和电荷的关系, \[ \varepsilon\nabla \vec E=-\rho=-q\left(p-n+N_D-N_A\right) \] 其中\(p,n,N_D,N_A\)分别是当地电子、空穴、施主电离、和受主电离的浓度,电场\(\vec{E}\)为电势的梯度, \[ - \nabla \psi = \vec{E} \] 在一维的情况下,有 \[ \varepsilon \frac{\mathrm{d}E}{\mathrm{d}x} = - \rho \] 平行板电容器电容器是最简单的电容器之一,但同时这种结构在半导体中出现得非常广泛,比如MOSFET的栅极区域,就构成了一个典型的金属-氧化物-半导体平板电容。平行板电容器由互相平行、以空间或绝缘体隔离的两片薄板构成。
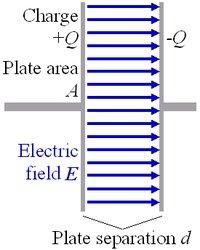
假设这两片薄板分别载有负电荷与正电荷,面电荷密度分别为\(-\sigma, +\sigma\),中间介电质的介电常数为\(\varepsilon\),薄板的间隔距离为\(d\),那么在两片板之间的电场强度就是 \[ E = \sigma / \varepsilon \] 两个板之间的电势差就是 \[ V = Ed = \sigma d / \varepsilon \] 自发极化是指由于晶胞内正负电荷中心不重合,形成电偶极矩,使得材料在极化方向上被诱导出了极化电荷,如下图所示。GaN和AlGaN都存在自发极化现象,使得各自层的表面上都出现了均匀的极化电荷,此时每一层就相当于是一个平行板电容器。在推导2DEG密度的时候,认为各材料的面极化电荷密度是已知的。
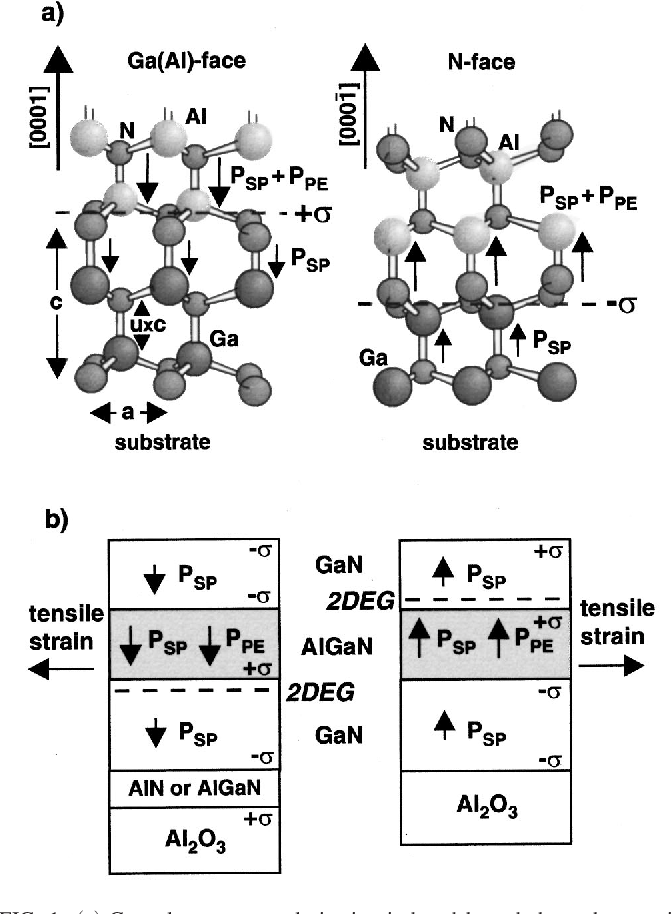
AlGaN/GaN异质结,相当于两个平行板电容器放到了一起。先单独考察AlGaN薄膜,横向代表厚度方向,其中\(E_s\)是一个表面施主态。首先由于自发极化,AlGaN层上表面诱导出了负的极化电荷,下表面出现了正的极化电荷,设极化电荷的面密度为\(\sigma_\text{AlGaN}\)。极化电荷诱导产生了电场,使得能带左侧电势被抬高。如果AlGaN薄膜比较薄,使得电势抬高后\(E_s\)还是低于费米能级,那么这个施主态中的电子并不会被激发,此时薄膜内没有足够的自由电子,能带并不会明显弯曲只会在极化电场的作用下倾斜。而当AlGaN薄膜足够厚的时候,左侧的施主态能级被抬高到高于费米能级,根据费米分布的特性,施主态开始电离,大量电子被激发到倾斜的导带上成为自由电子,在极化电场的作用下滑落到右侧区域,最终达到平衡态,费米能级拉平,导带在自由电子和极化电荷引起的电场的作用下发生弯曲。此时AlGaN的表面态上留下了等量的正电荷。
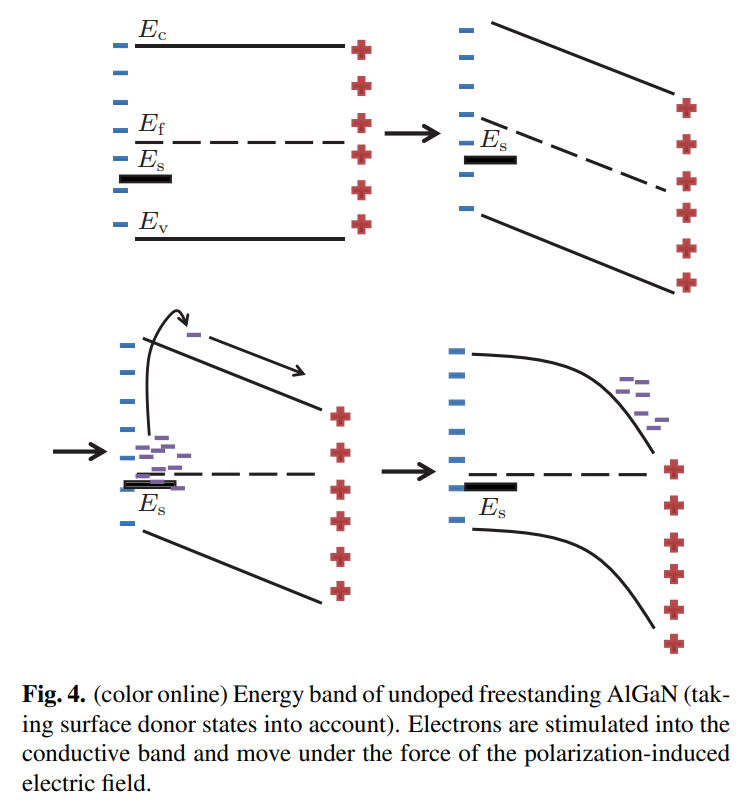
这样一块AlGaN薄膜,如果连接到一块GaN薄膜上,由于GaN的费米能级更低,堆积在AlGaN薄膜右侧的电子纷纷会流向GaN薄膜里,这时候GaN的费米能级也被卷到提高了,最后两侧的费米能级拉平,达到平衡态,电子不再发生移动,GaN的导带也在这些堆积的自由电子形成的电场作用下,形成一个又窄又深的势阱,里面的自由电子也就是2DEG了。

于是就可以估计2DEG的密度了。在AlGaN/GaN异质结体系中,一共有三对电荷,分别是表面态和二维电子气,\(|+\sigma_s|=|-n_s|\);AlGaN的极化电荷,\(|-\sigma_\text{AlGaN}|=|+\sigma_\text{AlGaN}|\);GaN的极化电荷,\(|-\sigma_\text{GaN}|=|+\sigma_\text{GaN}|\)。根据电容器的相关计算可以知道,每对电荷只对它内部板间区域的电场有影响。

于是可以列出AlGaN层的泊松方程: \[ \frac{\Delta V_\text{AlGaN}}{d} = \frac{\sigma_\text{AlGaN}}{\varepsilon} - \frac{qn_s}{\varepsilon} \] 其中\(\Delta V_\text{AlGaN}\)是AlGaN层的电势降,\(d\)是AlGaN层的厚度,\(\varepsilon\)是AlGaN的介电常数。此时,可以利用能带图,分别用AlGaN和GaN来列出电势的等式, \[ q\Delta V_\text{AlGaN} = q\phi_b + E_f - \Delta E_c \] 其中\(\phi_b\)是AlGaN上栅极接触形成的肖特基势垒高度,这大概可以用栅极金属功函数和AlGaN的电子亲和能来确定;\(E_f\)是GaN侧量子阱底部导带能量与费米能级的距离,这似乎需要通过求解量子阱的薛定谔方程来确定;\(\Delta E_c\)是异质结上的导带带阶,对于AlGaN/GaN界面导带带阶来说,\(\Delta E_c = 0.7 \Delta E_g\),\(\Delta E_g\)为禁带宽度之差,计算带阶只需要清楚 1. 真空能级不会突变;2. 半导体的电子亲和能是本征的性质,不会随着能带弯曲而改变。
把\(\Delta V_\text{AlGaN}\)代入到电势等式中,就可以得到, \[ n_{\mathrm{s}}=\frac{\sigma_{\mathrm{AlGaN}}}{q}-\frac{\varepsilon}{q^2 d}\left(q \phi_{\mathrm{b}}+E_{\mathrm{f}}-\Delta E_{\mathrm{c}}\right) \] 一个简单的2DEG面密度的估计式,这里没有考虑压电极化以及AlGaN施主掺杂的贡献。这些参数受温度影响的变化比较小,所以自热并不是降低2DEG密度使得输出电流降低。
self-heating
\[ I_D(T)=q n_s(x, T) v(x, T) \]
\(n_s\)的温度依赖性并不是太明显,所以HEMT电流驱动能力的下降主要取决于温度对沟道内电子速度的影响。电子运动有两种机制,一种是在电场力驱动下的漂移运动,另一种是受到浓度梯度驱动的扩散作用(实际上并没有这种驱动力,只是微观上的随机游走在宏观上的体现为扩散)。在HEMT里,显然沟道内电子运动的主要机制为漂移运动。为了描述电子在电场力下的运动,就引出了电子迁移率这个概念。在电场的作用下,电子获得加速度,速度增加。当载流子同晶体中的原子相碰撞后,载流子损失了大部分或全部能量。然后载流子重新开始加速并且获得能量,直到下一次受到散射,这一过程不断重复。因此,在整个过程中电子将具有一个平均漂移速度。假设电子的平均碰撞时间或者弛豫时间为\(\tau\),那么可以得到 \[ v = \frac{q\tau}{m^*} E= \mu E \] 其中\(m^*\)是电子的有效质量,\(\mu\)被称作迁移率。载流子速度越大,平均弛豫时间越小,在理想的弱电场情况下,漂移速度小于热运动速度,平均弛豫时间不变,此时载流子平均漂移速度和电场强度成正比,在高电场下,漂移速度影响总速度,平均弛豫时间减小,载流子迁移率减小,出现速度饱和现象。
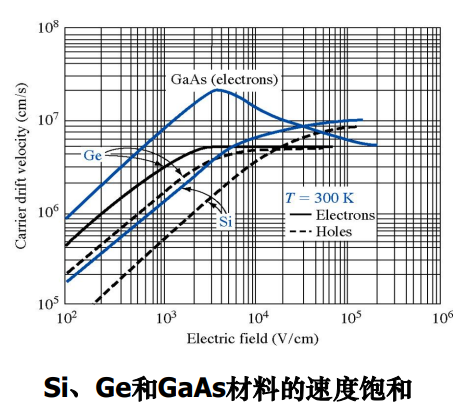
所以对于HEMT电子速度建模最简单的模型就是 \[ v(E)=\left\{\begin{array}{l} \mu E,E<E_{\mathrm{sat}} \\ v_\text{sat}, E \geqslant E_{\mathrm{sat}} \end{array}\right. \] 电场小于饱和电场时,速度和电场成正比;电场高于饱和电场时,速度达到一个稳定的饱和值。这个模型可以捕捉到两个阶段的主要特征,但是不够精细。在低场下可以仔细为迁移率建模,迁移率和散射是高度相关的,只要弄清楚半导体内的所有重要的散射机制,计算对应机制的散射概率,并且假设不同的散射机制彼此不相影响,这样就可以把所有的散射概率加起来得到一个总的散射概率,来计算总弛豫时间,最终就可以得到迁移率了。根据定义,散射概率就是弛豫时间的倒数。这种计算总弛豫时间的方式,我们称之为马西森定则, \[ \frac{1}{\tau} = \sum_i \frac{1}{\tau_i} \] 各种载流子都有类似的处理方式。所以对于AlGaN/GaN HEMT的迁移率建模来说,有些文章(Solid-State Electronics 54.1 (2010): 42-47.)有这样的形式, \[ \frac{1}{\mu(T)} = \mu_i^{-1} + \mu_\text{po}^{-1} + \mu_\text{ac}^{-1} + \mu_\text{pie}^{-1} \] \(\mu_i\)代表离子杂质散射,\(\mu_\text{po}\)代表极性光学声子散射,\(\mu_\text{ac}\)代表声学声子散射,\(\mu_\text{pie}\)代表压电散射,不同的散射机制有不同的表达式和拟合系数。
栅极电压引起的纵向电场也会在一定程度上影响2DEG的迁移率,比如一个唯象的模型是 \[ \mu_0\left(V_{g s}\right)=\frac{p_1}{p_2+\left(V_{g s}+p_3\right)^2} \] 假设电压偏置和温度的影响是独立的,那么迁移率可以表示成 \[ \mu_0\left(V_{g s}, T\right)=\mu_0\left(V_{g s}\right) \frac{\mu(T)}{\mu\left(T_0\right)} \] 在理想的体材料里,平均漂移速度和电场强度成正比,实际HEMT中电场也会有一定影响, \[ v(E, T)=\frac{\mu_0\left(V_{g s}, T\right) E}{1+\alpha_{\frac{E}{E_T(T)}}} \] \(E_T\)是临界电场,\(\alpha\)是针对具体器件的拟合系数。或者可以更简化一点,最终把沟道内的漂移速度整理成如下的形式,来更简单地观察温度和电场对电子速度的影响, \[ v(E, T)= \begin{cases}\mu_0\left(T_0\right)\left(\frac{T}{T_0}\right)^{-\alpha} E, & \text { low-field } \\ v_{\text {sat }}, & \text { high-field. }\end{cases} \] \(v_\text{sat}\)也有一定的温度依赖性,但并不显著。下面这张图展示了某个HEMT器件在\(V_g=0\,\text{V},V_d=10\,\text{V}\)时,AlGaN/GaN界面下方2.5纳米处电势、横向电流、横向场强以及产热的分布。整个沟道内明显分成了两个区域,一个区域是栅极下方的高场区域,一个是其他地方的低场区域,因为电流密度基本恒定,所以焦耳热分布基本和电场分布呈正比,因此也在栅极下方靠近漏极的一侧形成了一个局域热点,整个沟道的温度分布呈现出高场区域的尖峰向两边快速衰减的形式。那么结合上面对漂移速度的分析,这种双区域的温度和电场分布到底是怎样影响HEMT的输出电流的,chen等在2019年的TED上做了相关的讨论。
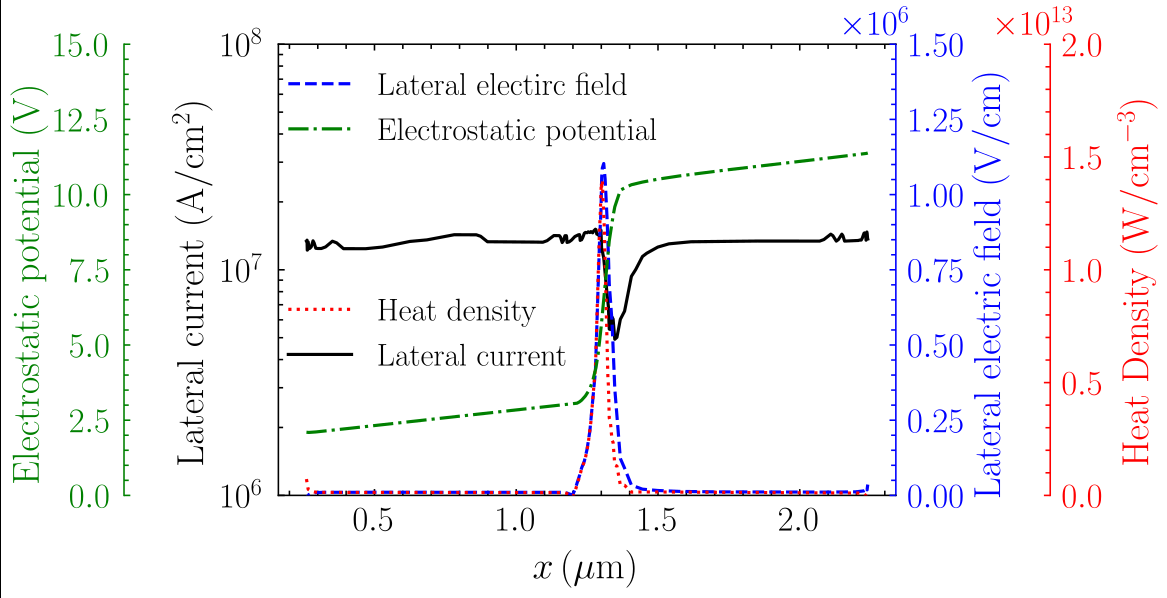
下面这张图是栅长100nm的一个HEMT的电热仿真结果,左侧是在不同偏置电压下沟道内温度场的分布,相比于不考虑自热效应,考虑了自热效应后HEMT的漏极电流会下降。其中\(T_{eq}\)指的是假设器件处于某个均匀温度\(T_{eq}\),这时器件的输出电流和电热仿真的输出电流相等,就把这个温度称之为等效温度\(T_{eq}\)。从左图可以看出来,这个等效温度要远远低于器件的结温,不同电压偏置下结温相差了超过50K,而等效温度的区别相差只有5K,这说明实际上器件的最高温度并不与器件的性能直接对应。中间这张图展示了器件分别处于300K、400K、500K的均匀温度时沟道内的电场、电子迁移率、以及电子速度。由于栅长很短,栅极覆盖的区域内电场强度非常高,使得这一部分的电子速度饱和,基本不受到温度的影响。在源极和栅极之间的区域电场比较低,这部分的阻值会显著受到温度影响,在源漏电压给定的时候,随着温度升高引起更高的电阻,使得器件的输出电流下降。右侧的这幅图,左边的曲线展示了漏极电流随着栅极-栅极靠近源极一侧边缘之间电压的变化,右边的曲线展示了漏极电流随着栅极-源极之间电压的变化,明显,左侧曲线基本不随着温度变化,而右侧曲线明显出现了随温度降低的情况,这也间接说明了HEMT中自热引起电流退化的机理。

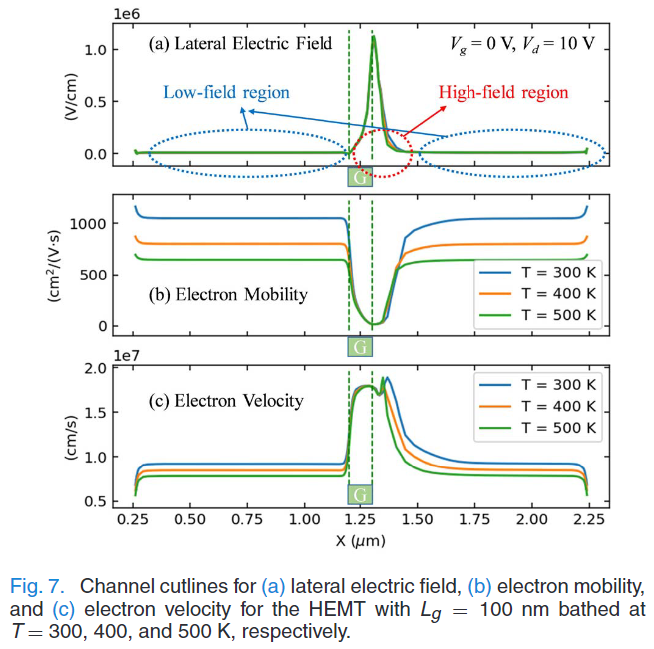
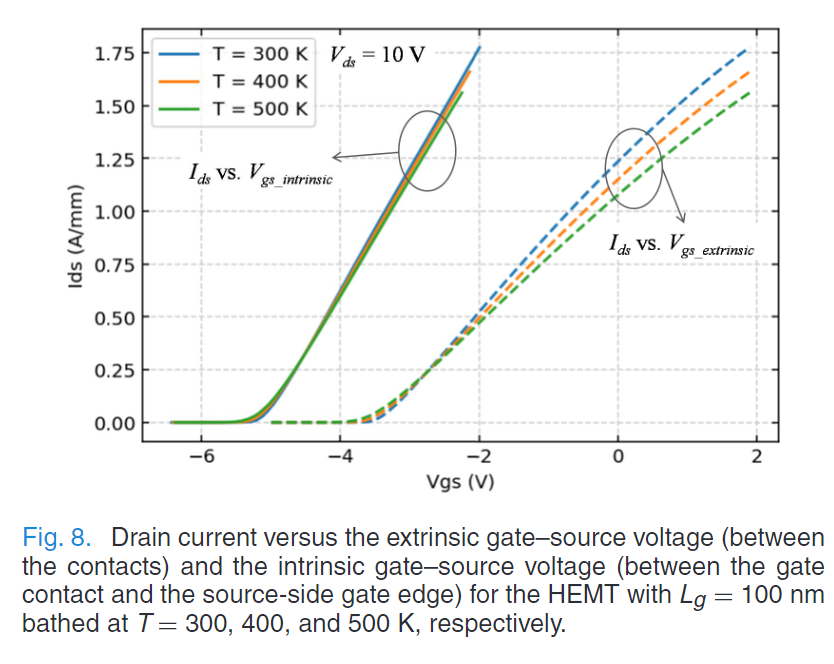
下面这两张图展示了具有更长一点栅极的HEMT不同偏置电压下的温度场分布,以及右侧不同温度浴下的沟道内的电场和电子速度分布。此时栅极靠近源极的一侧电场强度仍然很低,而由于栅极变长,导致相对来说的栅极靠近漏极下方的高场饱和区域变短,此时更多的区域容易受到温度的影响。因此,相比于短栅的GaN HEMT来说,长栅的HEMT的电流性能更容易受到温度的影响。

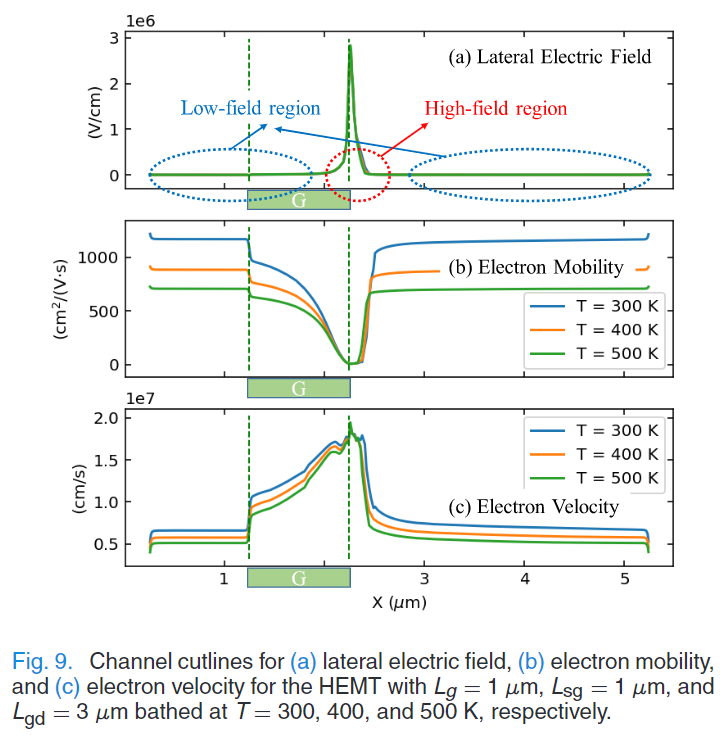
更过有关沟道内的偏置相关的高场和低场分布对HEMT器件热性能的影响,可以参考
Shen, Y., Chen, X. S., Hua, Y. C., Li, H. L., Wei, L., & Cao, B. Y. (2023). Bias Dependence of Non-Fourier Heat Spreading in GaN HEMTs. IEEE Transactions on Electron Devices, 70(2), 409-417.
Chen, X. S., Boumaiza, S., & Wei, L. (2020). Modeling bias dependence of self-heating in GaN HEMTs using two heat sources. IEEE Transactions on Electron Devices, 67(8), 3082-3087.
Reference
氮化物宽禁带半导体材料与电子器件,郝跃,科学出版社
半导体物理与器件,Donald A. Neamen,电子工业出版社
He, Xiao-Guang, De-Gang Zhao, and De-Sheng Jiang. "Formation of two-dimensional electron gas at AlGaN/GaN heterostructure and the derivation of its sheet density expression." Chinese physics B 24.6 (2015): 067301.
Pearson, Robert, et al. "Guidelines for reduced-order thermal modeling of multifinger GaN HEMTs." Journal of Electronic Packaging 142.2 (2020): 021012.
Ranjan, Kumud, et al. "Investigation of self-heating effect on DC and RF performances in AlGaN/GaN HEMTs on CVD-diamond." IEEE Journal of the Electron Devices Society 7 (2019): 1264-1269.
Chen, Xuesong, Slim Boumaiza, and Lan Wei. "Self-heating and equivalent channel temperature in short gate length GaN HEMTs." IEEE transactions on electron devices 66.9 (2019): 3748-3755.
Cheng, Xiaoxu, Miao Li, and Yan Wang. "An analytical model for current–voltage characteristics of AlGaN/GaN HEMTs in presence of self-heating effect." Solid-State Electronics 54.1 (2010): 42-47.