HEMT器件是怎么产热的
HEMT器件是怎么产热的
Chen X, Boumaiza S, Wei L. Self-heating and equivalent channel temperature in short gate length GaN HEMTs[J]. IEEE transactions on electron devices, 2019, 66(9): 3748-3755.
GaN HEMT是通过AlGaN和GaN之间形成的二维电子气导电的. AlGaN下面都是GaN,但是形成的导电沟道仅仅在AlGaN/GaN界面下方几个纳米的范围内,因此把界面下方比如5nm的GaN称作GaN channel layer,将剩下的GaN称作GaN buffer layer,GaN HEMT器件90%以上的热量集中在GaN channel layer处.
在电子器件中,主要的热源是焦耳热, \[ H = \vec{J} \cdot \vec{E} \] 其中\(\vec{J}\)是电流密度,代表单位截面面积电流量,单位为\(\mathrm{A/m^2}\), \(\vec{E}\)是电场强度,为电势的负梯度, \[ \vec{E} = - \nabla \psi \] 单位为\(\mathrm{V/m}\),焦耳热的单位为\(\mathrm{W/m^3}\). 对于HEMT器件来说,channel中二维电子气中的电流密度基本为常数,因此沟道处内的焦耳热可以用一个一维方程近似, \[ H_A \cdot \Delta x =I_D \cdot \Delta V \] 其中\(H_A\)为切面产热率,\(I_D\)为漏极电流,在channel中基本为常数,\(\Delta V\)为沿\(x\)方向的电压降. 因此从上面的近似表达式可以对HEMT器件的产热分布有一个直观的认识,产热密度和沿着沟道的电压降成正比,电压变化越剧烈的区域,产热也就越多. 当逐渐增加Drain电压\(V_d\)时,器件越发向饱和区移动,此时电压降更集中在gate下方靠近drain的一侧,因此产热会更加集中,在总功率一致的情况下,此时器件会有着更高的\(T_{\mathrm{max}}\),这也就是通常所说的bias dependence.
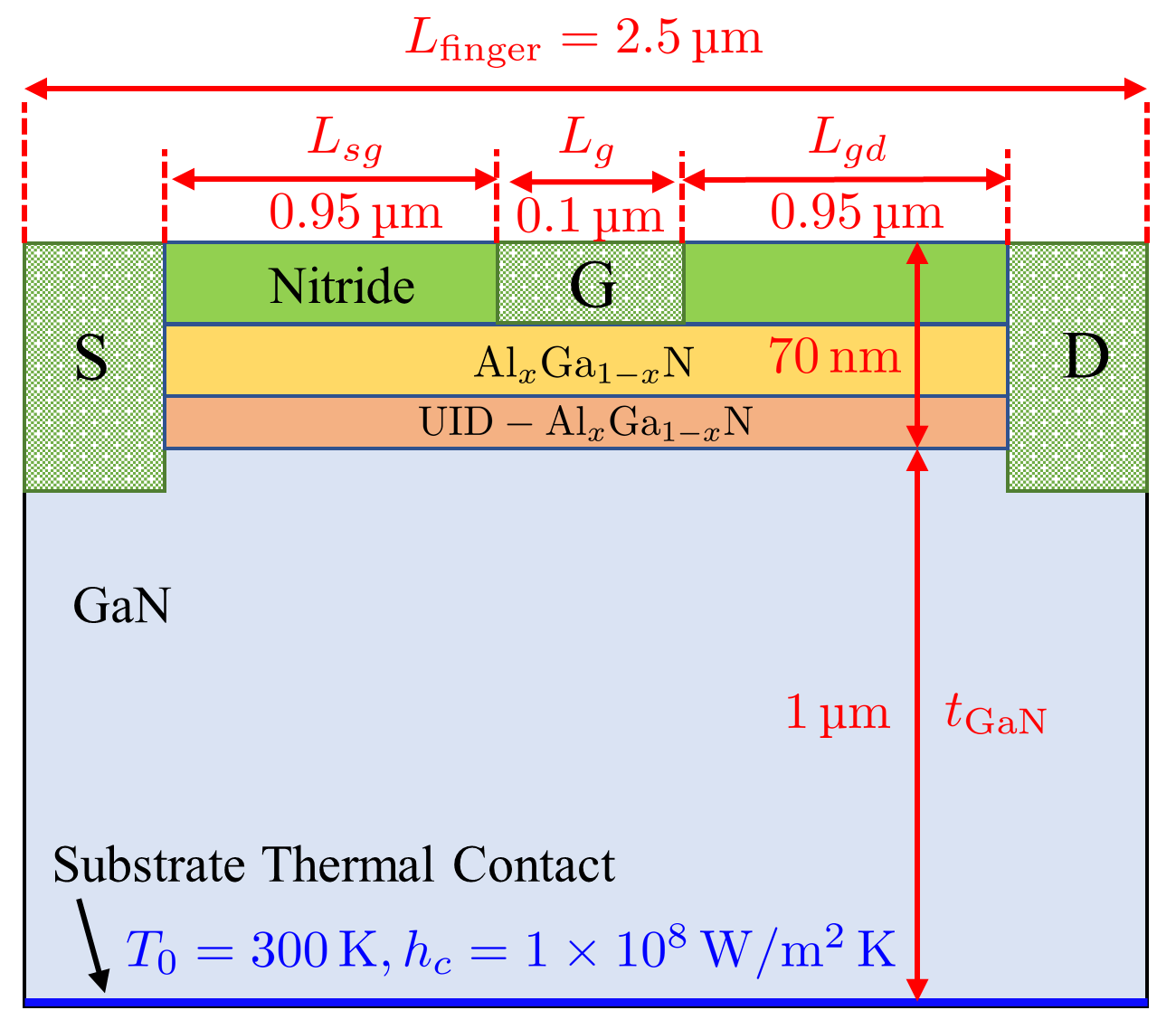
下面这张图是上面这个HEMT器件在\(V_g=0\,\mathrm{V}, V_d = 10\, \mathrm{V}\)时,AlGaN/GaN界面下方2.5纳米处电势、横向电流、横向场强以及产热量的分布. 电流密度基本保持在\(10^7\,\mathrm{A/cm^2}\),而电势在Gate靠近Drain的一侧剧烈地升高,导致了电场存在一个明显的尖峰,产热密度也因此呈现出和电场一样的尖锐的分布.