功率器件的全环绕金刚石冷却
功率器件的全环绕金刚石冷却
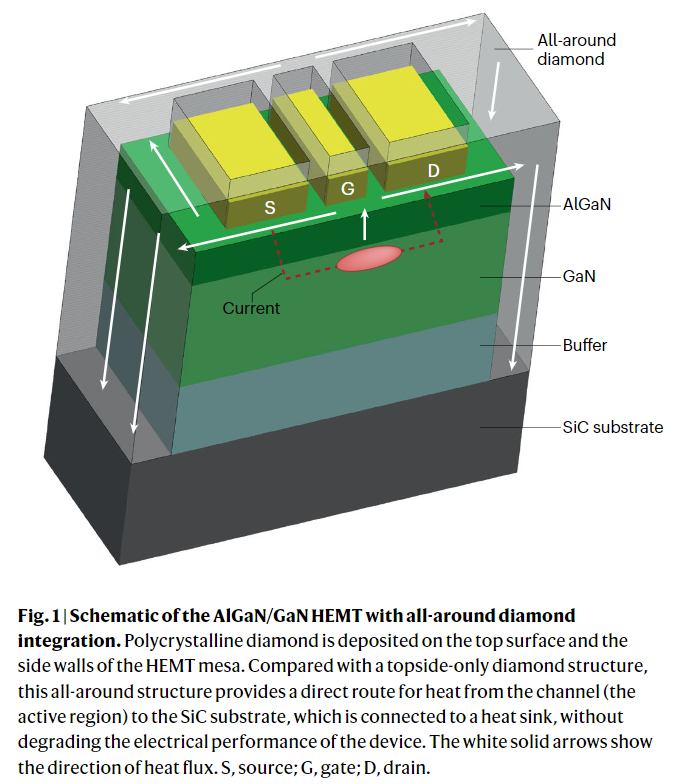
Ryou, Jae-Hyun, and Sukwon Choi. "All-around diamond for cooling power devices." Nature Electronics (2022): 1-2.
刚刚发表在Nature Electronics上的一篇news & views,只有一页半,作者是休斯顿大学的副教授Jae-Hyun Ryou和宾夕法尼亚州立大学的副教授Sukwon Choi。这篇news主要是介绍了一下金刚石用于AlGaN/GaN HEMT器件冷却的最新进展。文中提到的all-around金刚石冷却,是斯坦福在2022 IEEE IEDM会议上的一篇论文,
Paper #30.8, “Novel All-Around Diamond Integration with GaN HEMTs Demonstrating Highly Efficient Device Cooling,” R. Soman et al, Stanford Univ./Univ. Bristol/UC Santa Barbara/Georgia Inst. of Technology/Univ. Maryland)
IEDM在每年12月3-7号举行,是半导体器件领域最顶尖的会议,因为刚刚开完,所以会议论文集还没整理出来。纯器件方向最好的工作,会投到IEDM上;结果比较好比较新颖的工作,会投到EDL上;创新性低一些但更系统的工作,会投到TED上。APL和JAP上也有很多很好的工作,不过这两个杂志的覆盖内容就不只只是半导体器件了..
在半导体器件功率密度比较低时,封装级冷却(Package-level)已经可以起到很好的效果,即所有的电学部分先设计好封装完毕,在封装外面做外部冷却。但随着功率密度的提高,对于超高功率密度电子器件(大于\(50 \, \text{kW cm}^{-2}\)),比如GaN HEMTs,这时候封装级冷却已经无法满足需求,热量会大量积聚在器件内部。就像是病人发烧一样,就算是额头上贴了再多的冰块,身体里面还是滚烫的,因为主要矛盾在身体的内部。于是器件级冷却(Device-level)的概念出现了,直接改进器件结构的设计,让冷却方案(比如高热导率的金刚石)尽可能地靠近热源,使得热量能够从热点出发有效地传导出去。什么样的冷却方案才能尽可能接近热源呢?一个比较激进的想法可能是把冷却微通道直接打进器件里,比如2021年的Nature,
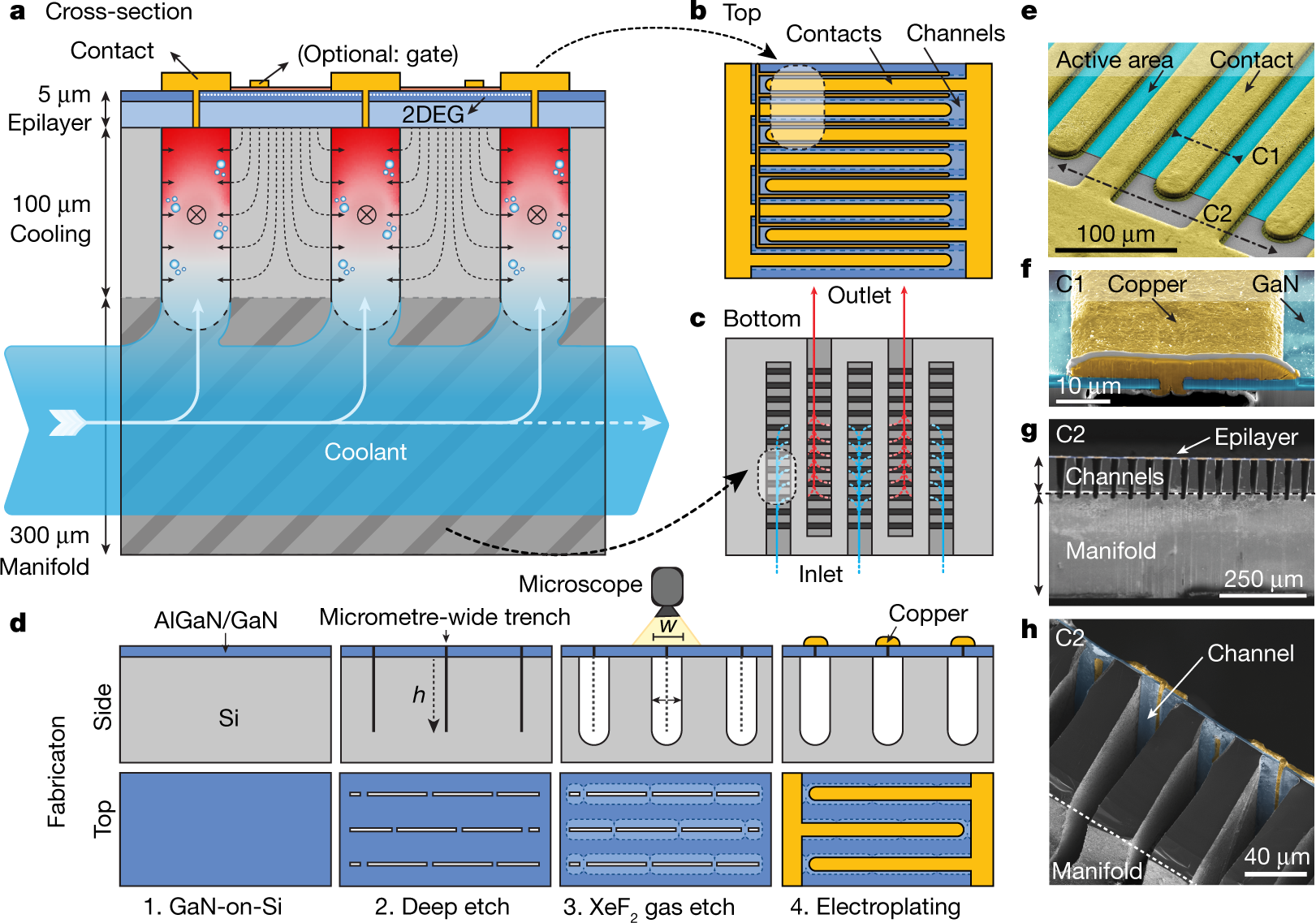
(Van Erp, R., Soleimanzadeh, R., Nela, L., Kampitsis, G., & Matioli, E. (2020). Co-designing electronics with microfluidics for more sustainable cooling. Nature, 585(7824), 211-216.)
但是器件级冷却需要满足以下几个基本需求:
- 导热能力高的同时要电学绝缘,跟热电的需求正好反过来
- 加工和制造的过程中不能够降低器件的电学性能
- 界面热阻应该比较小
- 在器件正常工况下不应该影响器件的结构完整性和机械可靠性。
所以微通道这个方案可靠性很难保证,不用说打进去了,放在外面也有这样的问题。最近几年,大家普遍觉得最有应用前景的方向是器件与高热导率材料的集成。这些高热导率材料,包括立方砷化硼,比如Gang Chen前几个月的Science;立方氮化硼,比如宋柏的Science;以及金刚石,AlGaN/GaN HEMTs和金刚石的异质集成是大家最关注的方向之一。异质集成具体的技术方案先不管,在哪边集成金刚石,一般可以分为三类,分别是底部放金刚石、顶部放金刚石、和两侧都放金刚石。这篇文章里提到的all-around,就更进一步,在四周都放上金刚石...
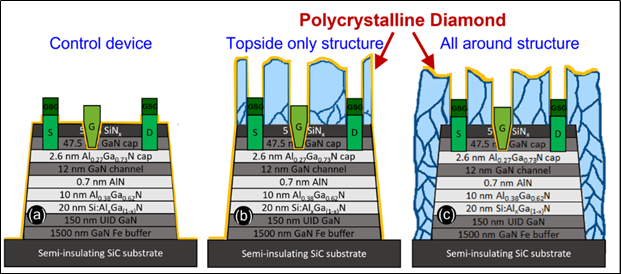
想法是很直观的,但技术实现上可能要考虑很多问题。IEDM的这个工作据说是开发了一种polymer-assisted seeding technique来实现这种all-around的集成,他们的实验结果表明,通过在一圈集成上500nm的多晶金刚石,可以使得结温降低100℃,同时使得沟道温度分布更加均匀,比在Top-side长上2.2微米的金刚石效果还要好一些,不过还没有全文,不知道具体细节是什么..